- 中华人民共和国工业和信息化部
- 中华人民共和国国家发展和改革委员会
- 中华人民共和国科学技术部
- 中华人民共和国国家统计局
- 中华人民共和国海关总署
- 中华人民共和国国家知识产权局
- 国家软件与集成电路促进中心
- 中华LED在线
- 中华显示网
- 《国际光电与显示》
- 韩国三星半导体集团
- 美国英特尔半导体研究集团
- 深圳市平板显示行业协会
- 深圳市平板显示行业协会触摸屏分会
- 中国半导体行业协会
- 上海市集成电路行业协会
- 广州市半导体行业协会
- 深圳市半导体行业协会
- 微信公众号二维码:

近日,中微半导体设备(上海)股份有限公司(以下简称“中微公司”)宣布通过不断提升反应台之间气体控制的精度,ICP双反应台刻蚀机Primo Twin-Star® 又取得新的突破,反应台之间的刻蚀精度已达到0.2A(亚埃级)。这一刻蚀精度在氧化硅、氮化硅和多晶硅等薄膜的刻蚀工艺上,均得到了验证。该精度约等于硅原子直径2.5埃的十分之一,是人类头发丝平均直径100微米的500万分之一(图1)。这是等离子体刻蚀技术领域的又一次创新突破,彰显了中微公司在技术研发上的深厚积累,进一步巩固了公司在高端微观加工设备市场的领先地位。

图1. 氧化硅、氮化硅和多晶硅晶圆在双反应台上刻蚀速度的差别
在200片硅片的重复性测试中,氧化硅、氮化硅和多晶硅的测试晶圆,在左右两个反应台上各100片的平均刻蚀速度相差,各为每分钟0.9埃,1.5埃和1.0埃。两个反应台之间平均刻蚀速度的差别(≤ 0.09%),远小于一个反应台加工多片晶圆刻蚀速度的差别(≤ 0.9%)。
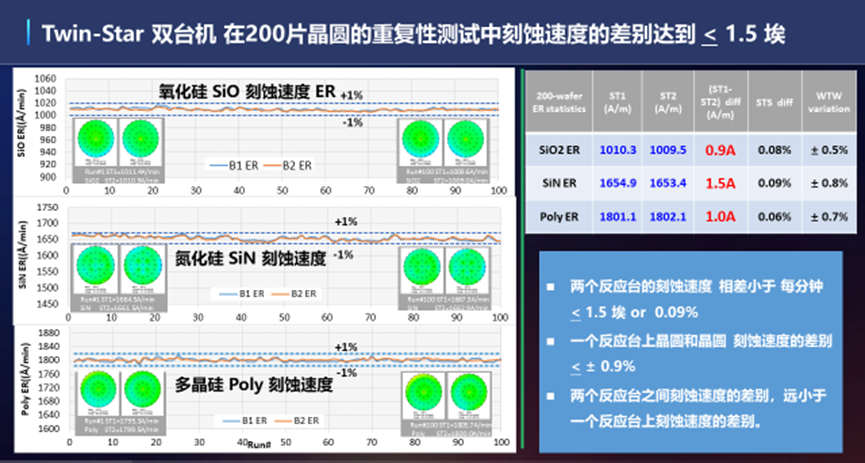
图2. 氧化硅、氮化硅和多晶硅各200片晶圆在双反应台上刻蚀速度的重复性
自2004年创立之初,中微公司始终坚持为达到设备的最高性能和满足客户最严要求而发开,致力于为客户提供高刻蚀性能、高生产效率和节约生产空间的刻蚀设备。2006年,公司研发的第一代双反应台电容耦合CCP刻蚀设备Primo D-RIE®在国际先进的逻辑客户的产线上成功得到核准,随之取得重复订单,得到客户的持续信任与支持。CCP的双台机 Primo D-RIE®和Primo AD-RIE®的加工精度,两个反应台的刻蚀重复性和在生产线上的重复性也早已达到和Primo Twin-Star®相同的水平。
在两个反应台各轮流加工1000片的重复性测试中,两个反应台的平均刻蚀速度相差,只有每分钟9埃,小于1.0纳米(图3)。在海外先进存储器生产线上,全年加工的12万片晶圆的全过程中,两个反应台在两个刻蚀应用上刻蚀速度的差别1sigma小于0.7%(图4)。
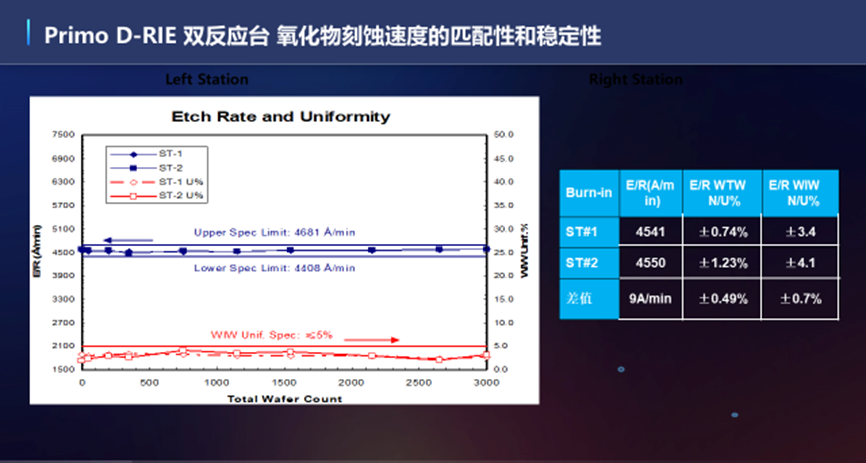 图3. 2000片晶圆在Primo D-RIE®双台机的重复性测试
图3. 2000片晶圆在Primo D-RIE®双台机的重复性测试

图4. Primo D-RIE®双台机12万片晶圆在存储器生产线上的重复性和匹配性
截至目前,Primo D-RIE®以及下一代产品Primo AD-RIE®在逻辑客户的产线上的量产反应台已经超过2000台,并有近600个反应台在国际最先进的逻辑产线上量产,其中相当一部分机台已在5纳米及更先进的生产线上用于量产。
中微公司首创了单反应台可以分别独立操作也可以同时操作的双反应台刻蚀反应器,是占地面积小、输出量高和成本低的刻蚀机。CCP和ICP的双台机已经证明了可以覆盖60%以上的刻蚀应用。大量的生产线数据表明,双反应台和单反应台刻蚀机呈现一样的刻蚀性能、刻蚀稳定性和可靠性。凭借行业首创的可独立工作的刻蚀设备双台机技术,通过超过20年的技术创新与经验积累,中微公司研发的电感耦合ICP刻蚀设备Primo Twin-Star®首次取得了0.2A的业界首创的刻蚀精度。该产品采用独创的低电容耦合LCC 3D线圈设计,双反应台腔体结构并结合创新的反应腔设计,可最大程度减弱非中心对称抽气口效应,可选多区温控静电吸盘(ESC)增强了对关键尺寸均匀性的控制,与其它同类设备相比,具有低成本、占地小和高产出的优异于特性,可应用于大多数先进逻辑和存储器的刻蚀制程。
 中微公司ICP双反应台刻蚀机Primo Twin-Star®
中微公司ICP双反应台刻蚀机Primo Twin-Star®
